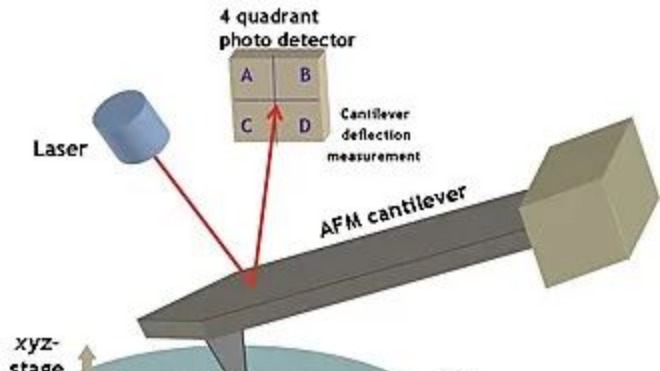

乌龙茶
引言
在半导体制造中,晶圆是承载晶体管和电路结构的关键基材。其表面任何微小缺陷都可能导致芯片失效,而划伤是最常见且破坏性极强的物理损伤之一。晶圆划伤测试是保障芯片质量的核心环节。

一、划伤测试的定义与作用
1. 定义
晶圆划伤测试是利用专业设备和技术,系统性发现、定位、识别和量化晶圆表面划痕类缺陷的过程。检测对象为晶圆表面,目标包括宏观划痕(肉眼可见)和微观划痕(需高倍显微镜观察)。检测时机通常在新机台装机、关键制程步骤后、晶圆传递时以及出货前。
2. 作用
提升产品良率:划痕可能导致芯片功能失效或潜在可靠性问题,提前发现可避免后续资源浪费。
保障芯片性能与可靠性:划痕会增加电阻、漏电流,削弱结构强度,影响长期可靠性。
监控工艺与设备状态:划痕数量或类型的异常可反映工艺或设备问题。
降造成本:早期发现划痕可减少报废和优化维护。
满足客户要求:高端客户对晶圆表面质量有严格要求,精确检测是质量控制的关键。
二、划伤测试流程与核心机台
1. 测试流程
计划与触发:基于工艺步骤、设备监控或批次历史制定检测规则,采用统计抽检或事件驱动触发。
取样与准备:自动化系统取出晶圆,读取标识并进行表面清洁(可选)。
自动化检测:使用自动缺陷检测机台(AOI),加载检测配方(Recipe),进行高速扫描。
缺陷检测与分类:通过图像处理系统识别划痕,并进行初步分类。
复查与确认:工程师使用高分辨率显微镜复查,确认划痕并修正误判。
数据分析与报告:上传数据至良率管理系统,生成可视化报告。
反馈与行动:根据报告调整工艺、维护设备或优化检测策略。
2. 核心机台
光学表面扫描仪(AOI):
主流检测设备,速度快、非接触,适用于在线和离线检测。利用可见光、紫外光(UV)或深紫外光(DUV)作为探测光源。核心优势: 速度快、非接触、无损伤、可检测多种表面缺陷(包括划伤、颗粒、残留物、水渍等)、覆盖宏观到亚微米级缺陷。适用于大部分工艺层后的检测。
代表厂商: KLA(科磊,市场领导者)、Applied Materials(应用材料)、Hitachi High-Tech(日立高新)、Onto Innovation等。
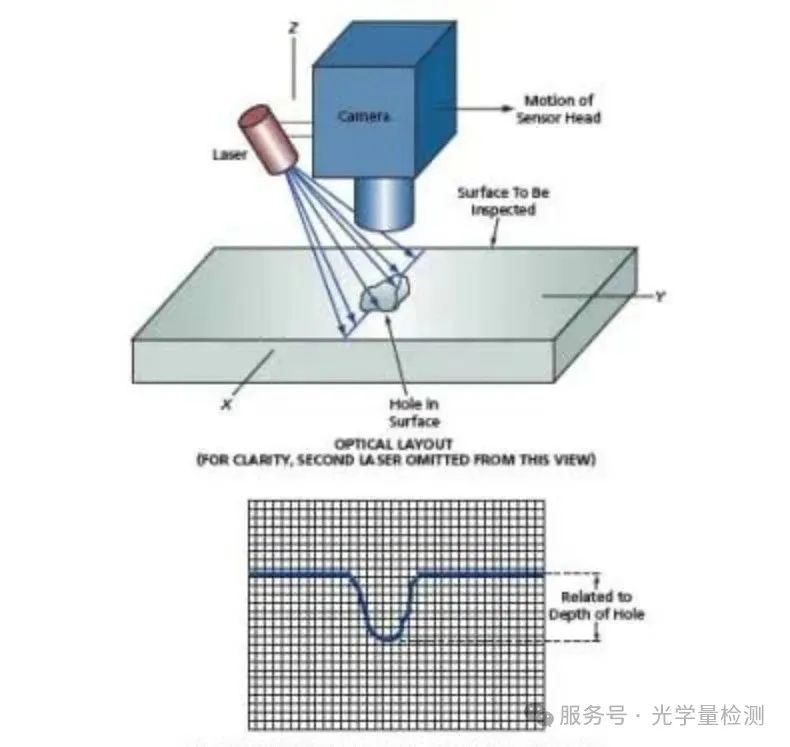
明场/暗场复查显微镜:
虽然AOI机台通常自带观察镜,但独立的、更高性能的明场/暗场显微镜是复查环节(Review)的标准装备。它们提供更高的光学分辨率和更灵活的照明模式。 用于工程师对AOI机台检测出的疑似划伤进行人工观察、确认、精细分类、测量和拍照存档。暗场成像尤其擅长凸显表面形貌变化(如划痕),使其在暗背景上呈现亮线。
代表厂商:KLA , Leica Microsystems(徕卡)、Olympus(奥林巴斯)、Nikon(尼康)、Zeiss(蔡司)等。
激光扫描显微镜(LSM)/共聚焦显微镜:
对AOI或工程师在普通显微镜下发现的关键或可疑划伤进行更深入的形貌分析,帮助判断其产生机制。 特点: 分辨率高(亚微米级)、能获得3D形貌、但速度相对较慢,通常用于离线、针对特定位置的深度分析(Failure Analysis),而非大面积快速普查。
代表厂商: Zeiss、Keyence(基恩士)、Olympus、Leica等。
扫描电子显微镜(SEM):
利用聚焦的高能电子束扫描样品表面,激发出二次电子(SE)和背散射电子(BSE)等信号成像。 提供最高的成像分辨率(可达纳米级),能清晰观察极其细微(Micro/Nano Scratch)的划痕形貌和边缘细节。 结合能谱仪(EDS)可进行划痕区域的微区成分分析,帮助判断划伤来源(如是否含有特定设备部件的材料成分)。特点: 分辨率极高、景深大、可做成分分析;但设备昂贵、操作复杂、需要真空环境、检测速度慢、通常对样品有导电性要求(非导电样品需镀膜),且是破坏性或有潜在损伤性的(电子束轰击)。主要用于离线、实验室环境下的深度缺陷分析(Defect Review SEM - DR-SEM)和失效分析(FA)。
代表厂商: Hitachi High-Tech(日立高新)、Thermo Fisher Scientific(赛默飞世尔,原FEI)、ZEISS、TESCAN(泰思肯)等。
原子力显微镜(AFM):原子级分辨率,用于科研级研究。
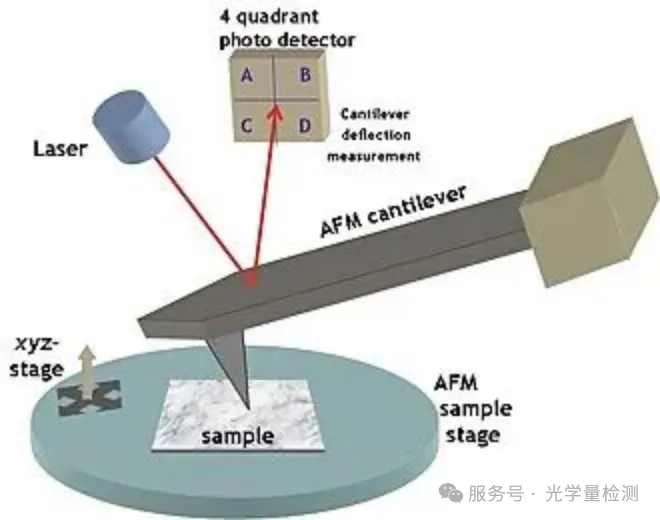
利用一个极细的探针(Tip)在样品表面进行扫描,通过检测探针与表面原子间微弱的相互作用力(原子力)来获得表面的超高分辨率三维形貌图。提供最高精度的划伤深度、宽度和剖面形貌测量(可达原子级分辨率),研究划伤底部的纳米级损伤和材料特性变化。特点: 分辨率最高(原子级)、可测量真实三维形貌、可在多种环境(空气、液体)下工作;但扫描速度极慢、扫描范围小(通常微米级)、操作复杂、对振动极其敏感。是极少数情况下用于最深度的、针对单个划伤的纳米级研究的科研级工具,在Fab常规划伤检测流程中应用非常有限。
代表厂商: Bruker(布鲁克)、Oxford Instruments(牛津仪器)、Park Systems等。
Fab中的晶圆划伤测试依托于高度自动化检测机台(AOI为主)、遵循标准化流程(采样-检测-复查-分析-反馈)、融合工程师经验(复查与判断)的精密体系。AOI机台如同“高速扫描仪”进行初筛,复查显微镜和高端显微分析设备(LSM/SEM/AFM)则如同“精密放大镜”和“深度剖析仪”,共同构成了Fab中监控晶圆表面完整性的“火眼金睛”网络。
三、划伤检测机台的工作原理
1. 光学检测原理
暗场成像(DF):倾斜光源照射,划痕散射光进入物镜,在暗背景上呈现亮线,对细微划痕敏感。
明场成像(BF):垂直光源照射,划痕因反射光减弱呈现暗线,适用于较深划痕。
其他模式:偏振光、多角度照明等可增强信号对比度。
2. AOI机台构造
晶圆处理与定位子系统:机械手臂、预对准器、精密晶圆台(卡盘和运动平台)。
光学照明子系统:激光器、宽谱光源、照明光路和偏振控制器。
光学收集与成像子系统:高NA物镜、科学级相机、自动对焦系统。
信号处理与控制系统:主控计算机、运动控制卡、图像处理硬件(GPU/FPGA)。
环境控制子系统:隔振系统、温湿度控制、洁净气流。
四、划伤的成因与防治策略
1. 划伤成因
设备硬件:机械手臂、卡盘、FOUP内衬的磨损或污染。
工艺过程:CMP抛光垫老化、研磨液污染、湿法清洗刷子问题。
颗粒污染:环境或设备内部颗粒在晶圆移动中引发划伤。
静电放电:局部放电导致微坑或裂纹。
晶圆自身:边缘质量差或翘曲增加划伤风险。
人为操作:不规范操作或维护引入缺陷。
2. 防治策略
设备选型与维护:选择晶圆友好设计,定期维护关键部件。
工艺优化:优化CMP、清洗工艺参数,减少颗粒产生。
颗粒控制:维持超高洁净度,管理FOUP和微环境。
静电防护:使用离子风机和防静电材料。
晶圆管理:严格检验来料,优化边缘处理。
人员培训:规范操作流程,强化洁净室行为。
持续监控:利用检测数据快速响应问题。
结论
晶圆划伤测试是半导体制造中不可或缺的质量控制环节。通过精密设备、标准化流程和综合防治策略,可最大限度减少划伤,保障芯片良率和可靠性。这是一项需要多部门协作的系统工程,需持续优化以实现最佳效果。